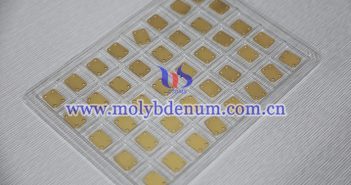
隨著集成電路向高性能、小型化和高集成度發(fā)展,三維封裝技術(shù)已成為半導(dǎo)體行業(yè)的主流趨勢(shì)。3D封裝通過(guò)將多個(gè)芯片垂直疊層,并利用垂直互連(如TSV,硅通孔)實(shí)現(xiàn)高密度…
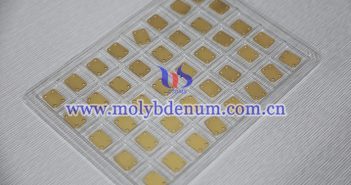
隨著集成電路向高性能、小型化和高集成度發(fā)展,三維封裝技術(shù)已成為半導(dǎo)體行業(yè)的主流趨勢(shì)。3D封裝通過(guò)將多個(gè)芯片垂直疊層,并利用垂直互連(如TSV,硅通孔)實(shí)現(xiàn)高密度…

隨著集成電路向高密度、小型化和高性能發(fā)展,三維封裝(3D packaging)技術(shù)已成為半導(dǎo)體封裝領(lǐng)域的重要方向。相比傳統(tǒng)二維封裝,3D封裝通過(guò)垂直堆疊芯片及其…
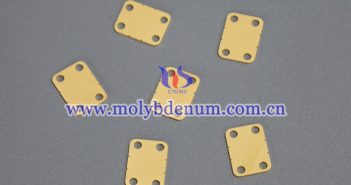
鉬銅合金是一種兼具高導(dǎo)熱性和低熱膨脹系數(shù)的金屬?gòu)?fù)合材料,廣泛應(yīng)用于電子封裝、熱沉材料以及高溫結(jié)構(gòu)件等領(lǐng)域。然而,由于鉬和銅之間存在較大的物理和化學(xué)差異,使得該類…

隨著電子器件向小型化、高集成、高功率密度方向發(fā)展,鉬銅合金的熱管理能力面臨更高的技術(shù)要求。如何進(jìn)一步優(yōu)化其熱導(dǎo)率、熱擴(kuò)散能力和熱應(yīng)力控制性能,成為當(dāng)前材料研究與…
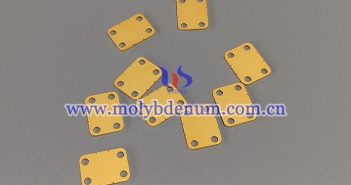
鉬銅合金(MoCu)作為高性能電子封裝材料,其表面處理技術(shù)對(duì)提升封裝可靠性和使用壽命起著決定性作用。隨著封裝工藝向高密度、小型化、極端環(huán)境適應(yīng)方向發(fā)展,此合金的…
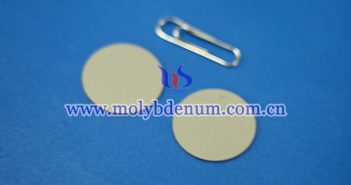
隨著集成電路技術(shù)的持續(xù)發(fā)展,傳統(tǒng)的二維平面封裝方式已難以滿足高性能計(jì)算、5G通信、AI芯片等領(lǐng)域?qū)π⌒突⒏呙芏取⒏邿崃髅芏鹊姆庋b需求。3D封裝技術(shù)作為一種新興…

在實(shí)際應(yīng)用中,鉬銅封裝的氣密性和長(zhǎng)期可靠性仍面臨諸多挑戰(zhàn),尤其是在極端環(huán)境(如真空、高溫、濕熱)下。因此,探索鉬銅合金封裝的氣密性與可靠性優(yōu)化策略具有重要的工程…
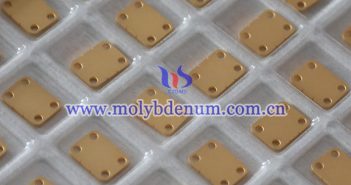
制造超薄型鉬銅散熱片不僅要保持合金的致密性和均勻性,還必須滿足高尺寸精度、優(yōu)良的表面質(zhì)量及結(jié)構(gòu)強(qiáng)度。傳統(tǒng)粉末冶金工藝雖然適用于中厚規(guī)格鉬銅合金的批量生產(chǎn),但在超…

鉬銅合金(Mo-Cu alloy)被廣泛應(yīng)用于高功率半導(dǎo)體器件的封裝熱沉、基板和散熱器等關(guān)鍵部件中。然而,由于該合金的表面化學(xué)性質(zhì)復(fù)雜、表面活性較低,直接用于封…
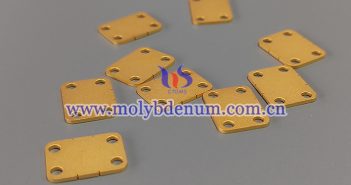
隨著半導(dǎo)體器件向高功率、高頻率和高集成度方向快速發(fā)展,芯片在運(yùn)行過(guò)程中所產(chǎn)生的熱量日益增加,對(duì)封裝材料的熱管理性能提出了更高要求。在眾多封裝材料中,鉬銅合金(M…