隨著集成電路向高性能、小型化和高集成度發(fā)展,三維封裝技術(shù)已成為半導(dǎo)體行業(yè)的主流趨勢。3D封裝通過將多個芯片垂直疊層,并利用垂直互連(如TSV,硅通孔)實現(xiàn)高密度、高帶寬、低功耗的封裝結(jié)構(gòu)。這一技術(shù)的發(fā)展對封裝材料提出了更高要求,特別是在熱管理、機(jī)械強(qiáng)度、熱膨脹匹配等方面。而鉬銅合金(Mo-Cu alloy)憑借其出色的導(dǎo)熱性能、低熱膨脹系數(shù)、良好的力學(xué)性能和可加工性,正在成為3D封裝中的關(guān)鍵支撐材料之一。
一、熱沉(Heat Sink)與熱擴(kuò)散板(Heat Spreader)
Mo-Cu合金最重要的應(yīng)用之一是作為熱沉或熱擴(kuò)散板。3D封裝由于芯片層數(shù)多、功率密度大,容易出現(xiàn)“熱點”聚集,從而影響器件性能和壽命。Mo-Cu合金具有較高的熱導(dǎo)率(可達(dá)180–220 W/m·K)和良好的熱擴(kuò)散性能,能迅速將芯片產(chǎn)生的熱量從封裝內(nèi)部導(dǎo)出,防止熱積累。同時,其熱膨脹系數(shù)介于硅(~3 ppm/℃)和銅(~17 ppm/℃)之間,通常為6–8 ppm/℃,與半導(dǎo)體材料及陶瓷封裝基板熱匹配性好,能有效減少熱應(yīng)力和開裂風(fēng)險。
二、基板支撐結(jié)構(gòu)(Substrate Support Structure)
在3D堆疊芯片結(jié)構(gòu)中,底部或中間芯片常常需要一個堅固、尺寸穩(wěn)定的金屬支撐材料以承載上層芯片的重量,并保障整個結(jié)構(gòu)在熱循環(huán)過程中不發(fā)生翹曲或變形。鉬銅因其高彈性模量和高溫穩(wěn)定性被用于作為封裝支撐板或中介層(interposer baseplate),確保封裝堆疊結(jié)構(gòu)的機(jī)械強(qiáng)度和長期可靠性。
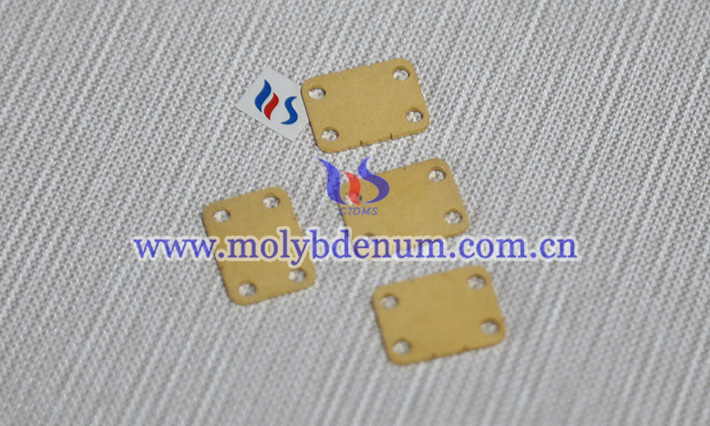
三、中介層(Interposer)導(dǎo)熱墊層
在硅通孔(TSV)或晶圓級3D封裝中,中介層(interposer)是連接上下芯片電信號與熱通路的關(guān)鍵元件。鉬銅可作為中介層的熱導(dǎo)路徑,起到穩(wěn)定的導(dǎo)熱橋梁作用。部分先進(jìn)工藝將Mo-Cu復(fù)合結(jié)構(gòu)與陶瓷中介層結(jié)合,以兼顧電性能與熱性能。
四、微型散熱片與定制熱結(jié)構(gòu)件
3D封裝對熱管理的局部化需求越來越高,尤其是在高功率計算芯片(如GPU、AI芯片)中。Mo-Cu合金可以被精密加工成微型散熱結(jié)構(gòu),如微槽、微柱或內(nèi)嵌散熱塊等,集成于封裝體內(nèi)部,以實現(xiàn)更高效的散熱控制。同時,由于其優(yōu)良的機(jī)械加工性能,可定制各種形狀以適應(yīng)不同封裝方案。
五、封裝蓋板(Lid)與導(dǎo)熱夾層(TIM Support)
在某些3D封裝模組中,鉬銅還被用作封裝外殼的蓋板,或作為熱界面材料(Thermal Interface Material, TIM)之間的穩(wěn)定支撐結(jié)構(gòu)。通過與高導(dǎo)熱硅脂、石墨片等材料協(xié)同使用,Mo-Cu蓋板可進(jìn)一步提升封裝整體的散熱效率和可靠性。
六、高頻、高功率封裝中的應(yīng)用
隨著5G通信和高頻雷達(dá)技術(shù)的發(fā)展,3D封裝逐步擴(kuò)展至高頻和高功率場景。鉬銅合金因其優(yōu)良的熱穩(wěn)定性、電磁兼容性和無磁性特性,被用于功率放大器模塊(PA module)、射頻器件(RF device)等器件的熱控底座和結(jié)構(gòu)支撐,為高頻信號傳輸提供堅實基礎(chǔ)。




